0 引言
垂直导电双扩散场( VDMOS )效应晶体管是新一代集成化半导体电力器件的代表[1]。与 功率 晶体管相比,具有输入阻抗高、热稳定性高、开关速度快、驱动电流小、动态损耗小、失真小等优点。因此VDMOS广泛应用在电机调速、工业控制、汽车电器等领域。但功率VDMOS的高压大电流的工作条件使得其功耗及自热效应相当明显,而温度的升高又必然会加速微电子器件的退化机理[2-3],对其 可靠性 造成严重影响甚至引起失效,且器件的失效必然会影响整个系统的正常工作,带来的损失不可估量。因此对功率VDMOS进行可靠性及失效分析显得尤为重要,国外对功率VDMOS的可靠性[4]进行了初步分析,国内也已经对GaAs微波场效应晶体管[5-6]进行了研究,但对功率VDMOS场效应晶体管的可靠性研究特别是其完整的可靠性数据和失效机理的研究还比较少。本文采用恒定温度应力加速寿命试验对功率VDMOS的可靠性进行了研究,得到较为完整的可靠性数据,并分析得到引起其漏源电流IDS退化的主要失效机理是栅极击穿,从而为功率VDMOS类型器件的加工制造及应用等方面提供有价值的数据。
1 理论
电子器件在正常工作状态下,很难在短时间内得到有价值的寿命数据。本文采用恒定应力加速寿命实验,通过施加温度应力,加速了元器件的参数退化,缩短了寿命,在短时间内得到必要的寿命数据。
以温度为加速应力的恒定应力加速寿命试验多采用 Arrhenius 模型 。该模型的阿列尼斯经验公式可以反映电子元器件寿命与温度之间的物理化学变化过程,即
![]()
式中:A为常数;k为玻尔兹曼常数;E为激活能;T为绝对温度;t为时间。
从式(1)中可以看出,寿命的对数与绝对温度的倒数之间满足直线方程,因此通过施加几组温度应力得到元器件在这几个温度点上的寿命后,利用这一关系外推出表征元器件失效机理的激活能E和正常温度下的元器件寿命。
若试验中采取不同的温度应力T1、T2,其他条件不变,要产生相同的退化量,所需时间分别为t1、t2,其比即为温度加速因子τ,则
![]()
2 结温的确定及试验
2.1 结温的确定
样管在室温(27℃)下的结壳热阻RJC=1.7℃/W(厂家提供)。样管偏置条件为VDS=7.5V、IDS=0.8A时,其在室温(27℃)下的壳温TC=107℃,由式(3)可得室温下TJ=117℃,即
![]()
式中:TJ为结温;RJC为结壳热阻;P为功率;Tc为壳温。
由热阻定义,利用室温下的数据,可以计算得到Rc-a=13.3℃/W,因此ΔTc-a=80℃,故环境温度为150、165、180℃时样管壳温分别为230、245、260℃,利用式(3)即可得到其对应结温分别为TJ150℃=240℃、TJ165℃=255℃、TJ180℃=270℃。
2.2 试验
试验器件为TO-3封装的n沟道功率VDMOS场效应晶体管。试验分三组进行,每组试验样品数均为6只,施加温度分别为150、165、180℃(对应结温分别为240、255、270℃),试验时间分别为1058、920、690h,偏置条件为VDS=7.5V、IDS=0.8A;试验前均对VDMOS场应晶体管特性(导通电阻、输出特性、转移特性)进行初测,测试周期为46h;失效判据为ΔIDS>初始值20%、ΔRDS>初始值20%、ΔIDSR>初始值20%,以大者为准。
3 试验结果与数据处理
3.1 参数退化
试验测试发现功率VDMOS的导通电阻、漏源电流、截止漏电流均发生退化,其结果见表1~3所示。



由表1~3所示结果,可以得出IDS退化是功率VDMOS的主要失效模式,因此以IDS的退化作为失效判据。
3.2 试验结果
失效样管(以3#为例)试验前后输出特性曲线对比如图1所示,温度应力为150℃,栅源电压为4.2~4.8V时,试验后(图中细线)样管漏源电流较试验前(图中圆点粗线)有明显降低,说明栅极控制能力减弱,栅极可能发生累积失效。
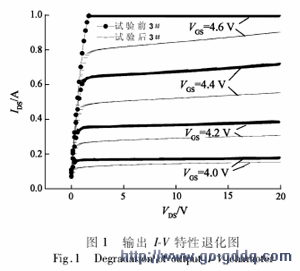
图2为试验中漏源电流IDS退化图(3#、7#、15#为例),其偏置均为VDS=10.1V、VGS=4.8V。可以看出在三组温度应力作用下,漏源电流IDS均出现不同程度的下降,且随着应力的增大,下降幅度增加,温度应力加速器件参数退化,与阿列尼斯方程符合较好。

本试验的失效分布图如图3所示,由图看出本试验在三组温度应力下,样管的失效分布呈三条相互平行的直线,说明在该试验中样管的失效机理是一致的,且由图可知较高的温度应力可以更快地加速参数退化,器件达到失效所需时间更短。此结果与恒定应力加速寿命试验理论相符,说明本试验是一个比较成功的恒定应力加速寿命试验。
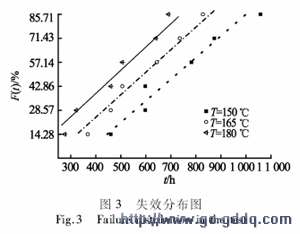
3.3 数据分析
本试验样本容量小,故采用精度较高的“最好线性无偏差估计”(BLUE)法进行数据处理。结果如下:①功率VDMOS在室温下(结温117℃)工作时的寿命特征值为3.67×106h;②功率VDMOS的主要失效模式是漏源电流的退化,其失效激活能E=0.54eV;③形状参数m的加权平均值m=1.373;④加速系数τ:τ(240~117℃)≈47.9145,τ(255~117℃)≈67.8953,τ(270~117℃)≈94.3733。